
以SiNx:H為例,在熱絲CVD(HoFCVD)反應過程中,其反應大致可以分為3個階段:
1.氣體分子與熱絲表面的碰撞反應:
HoFCVD鍍膜過程中,通過調節電流大小使熱絲維持在一個極高的溫度(2000K以上),當反應氣體分子碰撞到高溫熱絲,高溫熱絲能夠有效地裂解反應源產生相應的活性基團——Si、NH2、H,同時也會有SixNyHa、SiHy等之類的復合或混合活性基團產生。它們的能量很高(從熱絲表面脫離時,僅比熱絲溫度低幾百K)。
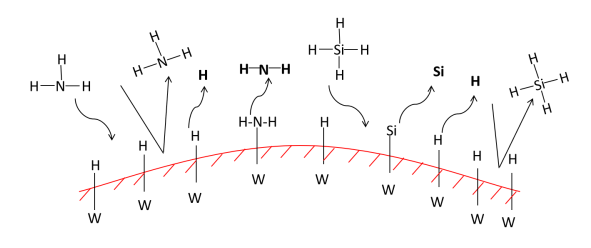
圖1. NH3和SiH4在熱絲表面的分解示意圖(熱絲溫度2000K);NH3在熱絲表面分解出H和NH2,而分解出的NH2和H碰撞還會反應生成NH和H2; SiH4在熱絲表面分解出H和Si。
2.從熱絲表面到襯底之間氣相中的反應:
因為HoFCVD不依賴分子間碰撞產生活性基團,所以腔室內工藝氣壓可以很低(~1Pa),這些活性基團和氣體分子間發生碰撞的概率低,這導致活性基團攜帶的能量在氣相傳輸過程中與氣體分子發生碰撞造成損耗的概率和程度很低,從而導致這些活性基團得以攜帶很高的能量達到襯底表面。同時,碰撞概率低,意味著氣相中發生的副反應更少,副產物也更少。
3.在襯底表面的反應:
活性基團達到襯底表面后發生的一系列反應的劇烈程度取決于反應基團本身攜帶的能量(溫度)以及襯底溫度二者的疊加。因此,由于HoFCVD中活性基團能量足夠高,在襯底表面即使不進行加熱,反應基團攜帶的能量也足以高到可以反應生成SiNx。
再進一步,在襯底表面發生的反應又可細分為三個特征過程(可類比為:氣-液-固三相反應):
1)襯底的極表面發生的氣-固反應:各種氣相基團與襯底表面的原子直接反應,發生沉積或者刻蝕。這個特征過程最為復雜,可發生的反應以及同時發生的反應很多。這個過程中最經典的為硅薄膜的沉積,以及逆反應的硅薄膜被氫氣刻蝕。
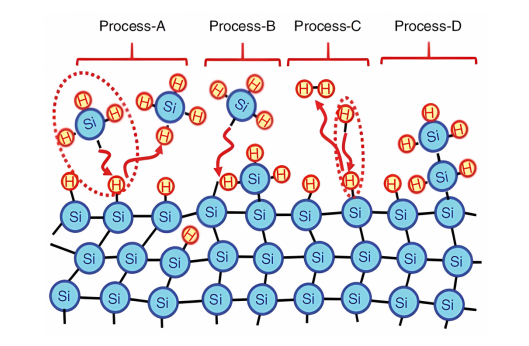
圖2. 非晶硅薄膜生長表面模型。去除覆蓋在表面上的H原子是薄膜正常生長的關鍵。
圖來源:Matsumura H, Umemoto H, Gleason K K, et al. Catalytic chemical vapor deposition: technology and applications of Cat-CVD[M]. John Wiley & Sons, 2019.

圖3. 非晶硅表面的Si-Si弱鍵被氫刻蝕
2)基團在襯底表面的遷移和固相反應:硅薄膜中微晶成分的生產、氮化硅、氧化硅相的生產,均與該過程有很大關系。
3)基團在形成固相薄膜后的應力調整和少量基團的短程位置調整:生產薄膜中應力的調整、折射率的微小變化等。
所以,襯底加熱,對生成SiNx薄膜的結晶性、細微結構、應力等性能指標是明顯影響的。
HoFCVD設備由于活性基團平均自由程較大,所以氣相中副反應更少,有以下兩個優點:一是有更多利于成膜的活性基團(如Si、NH基團)直接落到襯底表面,鍍膜速度更快;二是有更多的H原子到達膜層表面,可以對質量較差的區域形成刻蝕以及鈍化作用,同時可以帶走膜層表面的H,降低膜層氫含量。
綜上,我們可以看出,熱絲CVD中有兩個溫區,一個是高溫熱絲,另一個是襯底。主要由高溫熱絲給基團提供能量使其具有活性,而襯底溫度僅起到輔助熱的作用。熱絲溫度決定了反應基團的溫度和生產的物質的主要化學鍵,襯底溫度會促使薄膜結晶、應力改變等。所以,在HoFCVD中,在低的襯底溫度下也可以實現很多種薄膜的制備。
掃二維碼用手機看
相關資訊
- BC技術中HoFCVD的顛覆性應用示例 2025-07-18
- Cat-CVD技術現狀、研究歷程及產業化應用現狀 2025-04-24
- 【喜訊】熱烈祝賀我司榮獲”2025年度光伏設備品質卓越獎” 2025-04-22
- 電池片切割邊緣鈍化的HoFCVD解決方案 2025-04-13
- 為什么熱絲CVD(HoFCVD)可以實現低溫(室溫-200℃)薄膜的制備? 2025-04-03

微信公眾號
聯系我們
電話:13387083439 劉經理
郵箱:cliu@hactech. cn
網址:www.zhhuaming.com
地址:江西省九江市共青城市國家高新區火炬五路
地址:江蘇南通蘇錫通科技產業園區海堡路6號中新智能制造產業園9號樓
Copyright ?2021 江西漢可泛半導體技術有限公司 贛ICP備2021002933號-1 網站建設:中企動力 南昌 本網站已支持IPv6






 贛公網安備36048202000059號
贛公網安備36048202000059號